
主要生產和銷售金(jīn)剛石
和立方氮化硼製品
全國服務熱線
15981998378
隨著半導體工業(yè)的迅猛(měng)發展,市場對於更高性能半導體材料(liào)的需求日(rì)益增長。金剛石以其獨特的物理與化學特性,有望在下一代半(bàn)導體產業(yè)中扮演更(gèng)加重要的角色。金剛石(shí)憑借其優異的導熱性能、超寬的禁帶結構以及較高(gāo)的(de)載流子遷移率,在高功率、高頻及高溫環境下的電子器件中展現出巨大的應用潛力。然而,金(jīn)剛石的極高硬度猶如(rú)一把(bǎ)雙刃劍(jiàn),既是性能卓越的基(jī)石,也為加工過程(chéng)帶來了前所未有的挑戰。這一特性使得傳統機械切割工藝在應對金剛石時,麵臨著材料損耗(hào)大、加工效率低等瓶頸。特(tè)別(bié)是在大尺寸金剛石的精密製造過程中,加工良率的提升與成本的有效控製,已成為製約金剛石在尖端科技(jì)領域實現廣泛應用的兩(liǎng)大核心障礙。
在此嚴峻形勢下,大族激光旗下全資子公司大族半導體聚力攻克(kè)金剛石激(jī)光切片(piàn)技(jì)術(QCB for diamond),在金剛石(shí)加工領域帶(dài)來了顛覆性的創新突破。這項技(jì)術不(bú)僅極(jí)大提升(shēng)了加工效率與良率,更將(jiāng)有效降(jiàng)低生產成(chéng)本,為金剛石在高性能電子器件、量子(zǐ)計算、高功率激光等多個(gè)前沿(yán)科技領(lǐng)域的廣(guǎng)泛應用奠定(dìng)基礎。
技術原理
金剛石的激光切片(piàn)技術利用激光在材料內部進行非接觸性改(gǎi)性加工,通過**控製激光在材料內部的作用位置,實現材(cái)料的分離。這一技術主要(yào)包括兩個步驟:首先,激光束精準(zhǔn)聚(jù)焦在晶錠的亞表麵特定(dìng)深度,形成(chéng)一層經過改質(zhì)的(de)材料區域。這一(yī)步驟(zhòu)中,激光誘導(dǎo)的物理和化學變(biàn)化使(shǐ)改質層內的材料性質發生變化,為後續裂紋的引導擴展打下基礎。接著,通過施加外(wài)部應力,如機械力或熱應力,引(yǐn)導裂紋沿著指定平麵擴展,實現晶片的無損分離。整個過程中,激(jī)光的高(gāo)能量密度使得材料內部發生物理和化學變化,確(què)保了分離過(guò)程的**性和高效性。
與碳化矽晶錠不同,金剛石(shí)的解理麵與晶圓切片(piàn)方(fāng)向存在較大的(de)角度差異(yì),這使得剝離麵的起伏更難控製。因此,在實際加工(gōng)過程中,必須**調節激光的能量(liàng)和光學調製(zhì),確保激光能量分布均勻、作用位置**,從而有效控製裂紋的擴展方向及剝離麵的(de)平整度。整個過程中,超快激光脈衝的高能量密度引入,使得材料內部超短時(shí)間和空間尺度內發生劇烈的物理和(hé)化學變(biàn)化,這種高(gāo)精度的能量控製確保(bǎo)了分(fèn)離過程的**性和(hé)高效性。
綜上(shàng),相(xiàng)比傳(chuán)統的機械加工方法,激(jī)光切片具有許多顯著優勢。首先(xiān),它是一種非接觸性加(jiā)工方式,避免(miǎn)了(le)機械應力對晶錠的損傷,減少了碎裂和微裂紋(wén)的(de)風險。其次(cì),激光切片能夠實現極(jí)高的加工精度和質量,特別適用於金剛石(shí)這種硬(yìng)度高、脆性大的材料(liào)。QCBD激光切片工藝大大減少了材料的浪費,提高了材料的利用率以及(jí)加工效率,這(zhè)對於高價值的金剛石材料尤為重要。
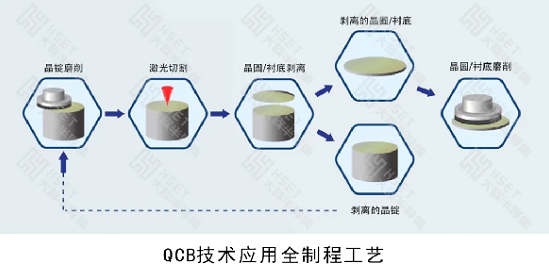
目前在商業應用方麵,金(jīn)剛石激光切(qiē)片設備尚處於初期研發階段。與碳化矽晶錠加工(gōng)技術相比,金(jīn)剛石切片技術的商業化(huà)進程(chéng)相對滯後。由於金剛石的物理性質極為特殊,如何在保證切割質量的前提下實現大規模生產是技術研發麵臨的重大挑戰。
近期,大族半導體在(zài)金剛石切片領域取得了(le)重要的技術(shù)突破,推出了QCBD激光切片技術及其相關設備,實現(xiàn)了金剛石高質量低(dī)損傷高(gāo)效率激光切(qiē)片。這一(yī)成果標(biāo)誌(zhì)著激光切片(piàn)技術在金(jīn)剛石材料加工中取得重要進展,填(tián)補(bǔ)了國內在(zài)該領域(yù)的技術空白。通過(guò)對激光能量的**調控與光(guāng)束形態的調製,大族半導體克服了(le)金(jīn)剛石解(jiě)理麵{111}與切(qiē)片方向{100}之間較大角度帶來的加工難題,實現(xiàn)了晶(jīng)錠的高精度、低(dī)損(sǔn)傷(shāng)剝離。根據大族半導體QCB研究實驗室研究數據(jù)顯示,使用(yòng)該技術,剝(bāo)離後粗糙度Ra低至3μm以內(nèi),激(jī)光損傷層可大(dà)幅度降低(dī)至20μm。這項技術突破將大幅降低金剛(gāng)石的加工成本,推動其在電子、光學等(děng)高(gāo)端領域(yù)的廣泛應用。
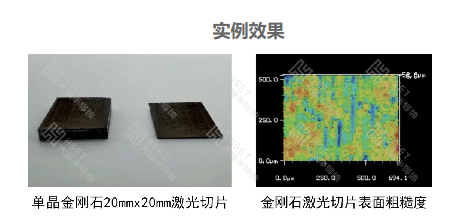
大族半導體研發的金剛(gāng)石激光切片技術,憑借出眾的加工效能,已成功攻克半導體材料加工技術領域的(de)眾多(duō)棘(jí)手難(nán)題。這一技術的突破,不僅顯著加速了生產流程,將生產效率(lǜ)推向新高,而且精細入(rù)微的工藝確保(bǎo)了產品質量的飛躍式提升(shēng),同時,通過優化生產流程(chéng),有效降低了製造成本,展現(xiàn)出了極為廣闊的市場應用(yòng)前景,預示著其在未來的***製造領域中必將占(zhàn)據舉足輕(qīng)重的地位,**半導體材料加工技術邁(mài)向一個全新的發展階段。
phones
電話:15981998378 聯係人:程先生
ADDRESS
地址:河(hé)南省鄭(zhèng)州(zhōu)市高新區(qū)蓮花街電(diàn)子電器產業園338號(hào)
郵箱:zhengzhouchengzhen@163.com
請認真(zhēn)填寫需求信息,我們會在(zài)24小時內與您取得聯係